|

|
- METAL
- ALUMINUM, ALUMINUM ALLOY
- NICHEL
- TITANIUM
- GOLD
- CHROME
- SILICON/POLYSILICON (H2O + HF + HNO3)
- SILICON OXIDE (DILUTED HF, BUFFERED HF)
|
| PLASMA ETCHING AND ASHING |
|
RIE PLASMALAB u80
|
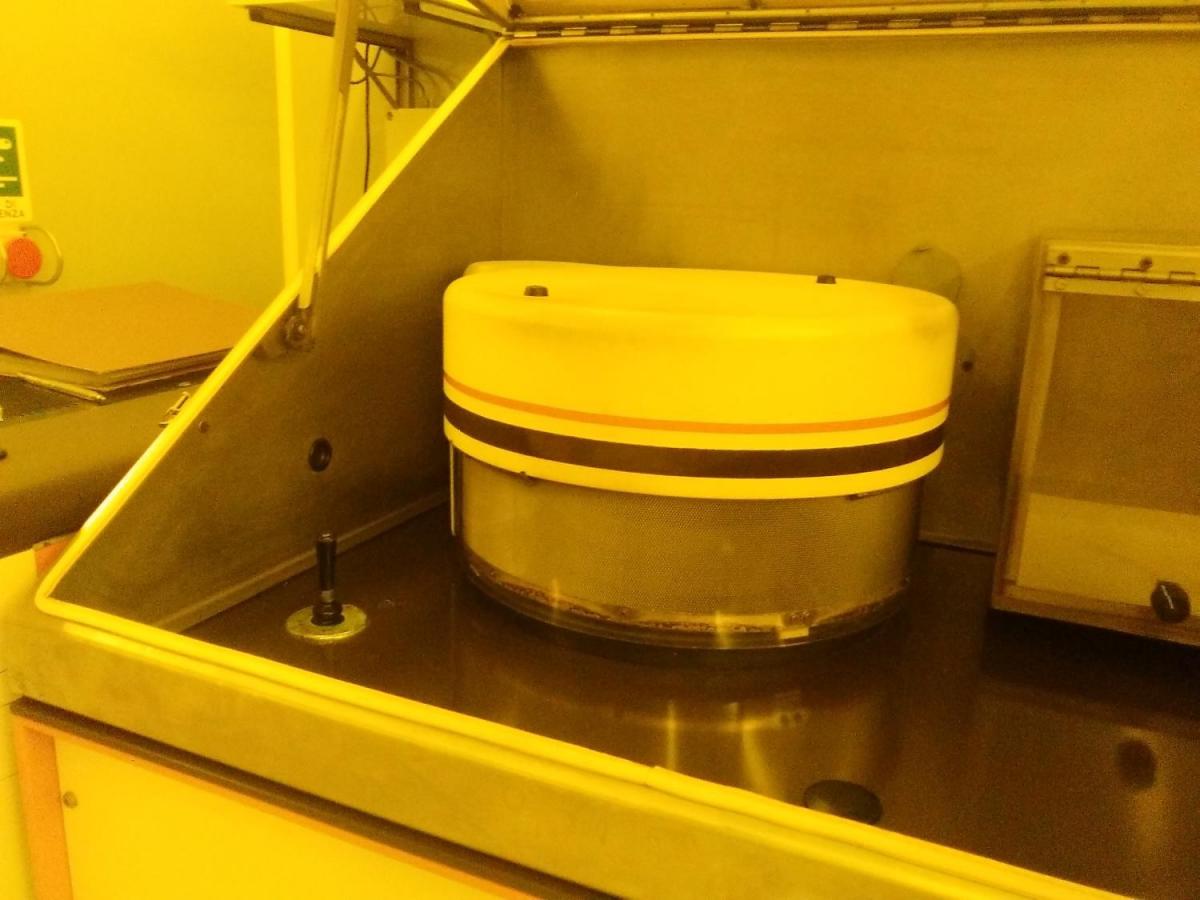 |
- THIN FILM ETCHING
- SILICON AND POLYSILICON ETCHING CHLORINE BASED PLASMA
- ETCH RATE UP TO 50 nm/min
- MAX THICK FILM: 2000 nm
- SILICON OXIDE, SILICON NITRIDE FLUORINE BASED PLASMA
- ETCH RATE UP TO 30 nm/min
- MAX THICK FILM: 2000 nm
- SILICON CARBIDE ETCHING
- ETCH RATE UP TO 30 nm/min
- MAX THICK FILM: 1500 nm
- SUBSTRATE: SILICON, SiC, FUSED SILICA
- DIMENSION: UP TO 4" WAFER
- CMOS COMPATIBLE SUBSTRATE ONLY
|
 |
RIE SENTECH SI 591
- THIN FILM METAL AND SILICON ETCHING
- ALUMINUM ALLOY ETCHING CHLORINE BASED PLASMA AND PASSIVATION PROCESS
- ETCH RATE: UP TO 100 nm/min
- SILICON/POLYSILICON ETCHING BY SF6/O2 PLASMA: ANISOTROPIC AND ISOTROPIC ETCHING
- ETCH RATE FROM 200 nm/min UP TO 1 um/min
|
| |
TEPLA PLASMA OXYGEN
|
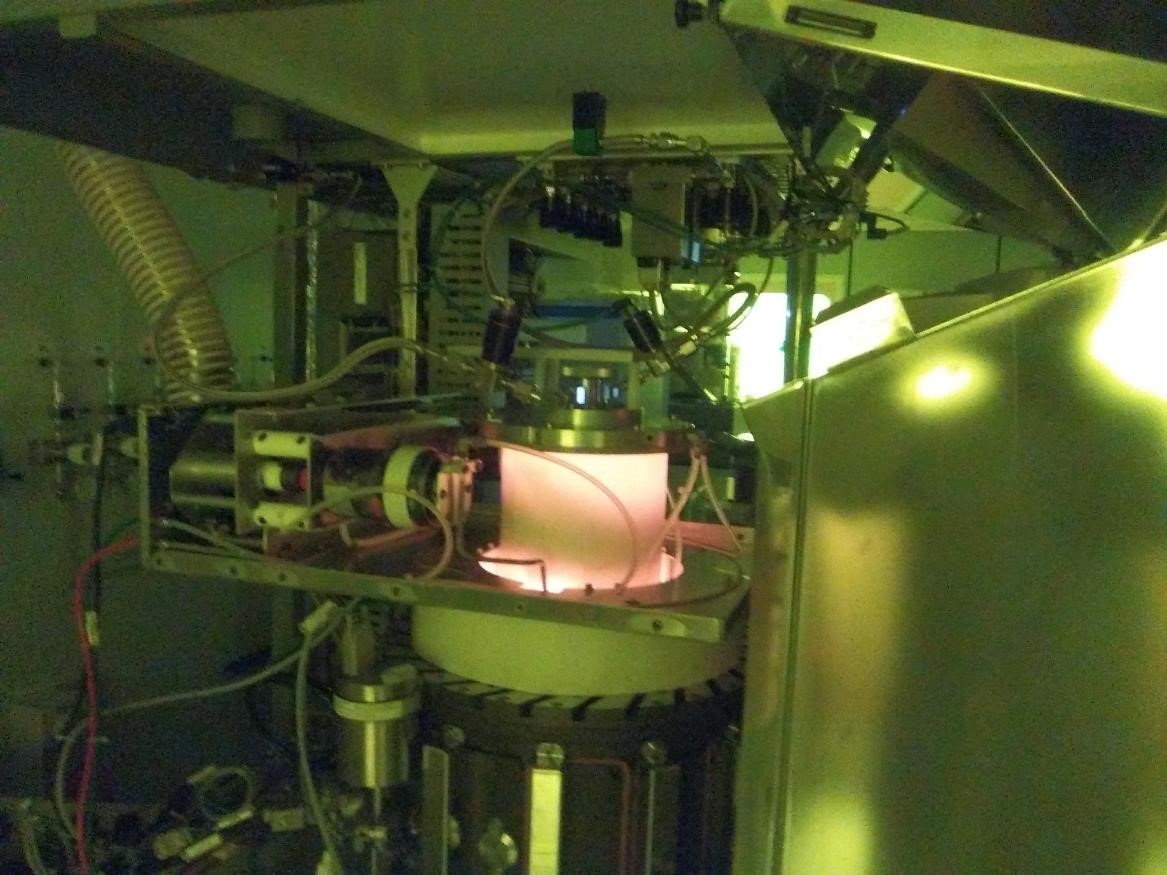 |
DEEP REACTIVE ION ETCHING ALCATEL A601E
- DEEP ETCHING OF SILICON AND SILICON OXIDE
- ANTI-NOTCHING SYSTEM
- DIFFERENT PROCESSES ARE AVAIABLE
- HIGH ETCH RATE PROCESS (UP TO 12 um/min)
- LOW ROUGHNESS PROCESS (UP TO 2 um/min)
- THROUGHT WAFER ETCHING
- DEEP SILICON OXIDE ETCHING UP TO 10 um
FOR MORE INFORMATION: MICROSYSTEM PROCESS
|
| SUBSTRATE CLEANING AND POLISHING |
|
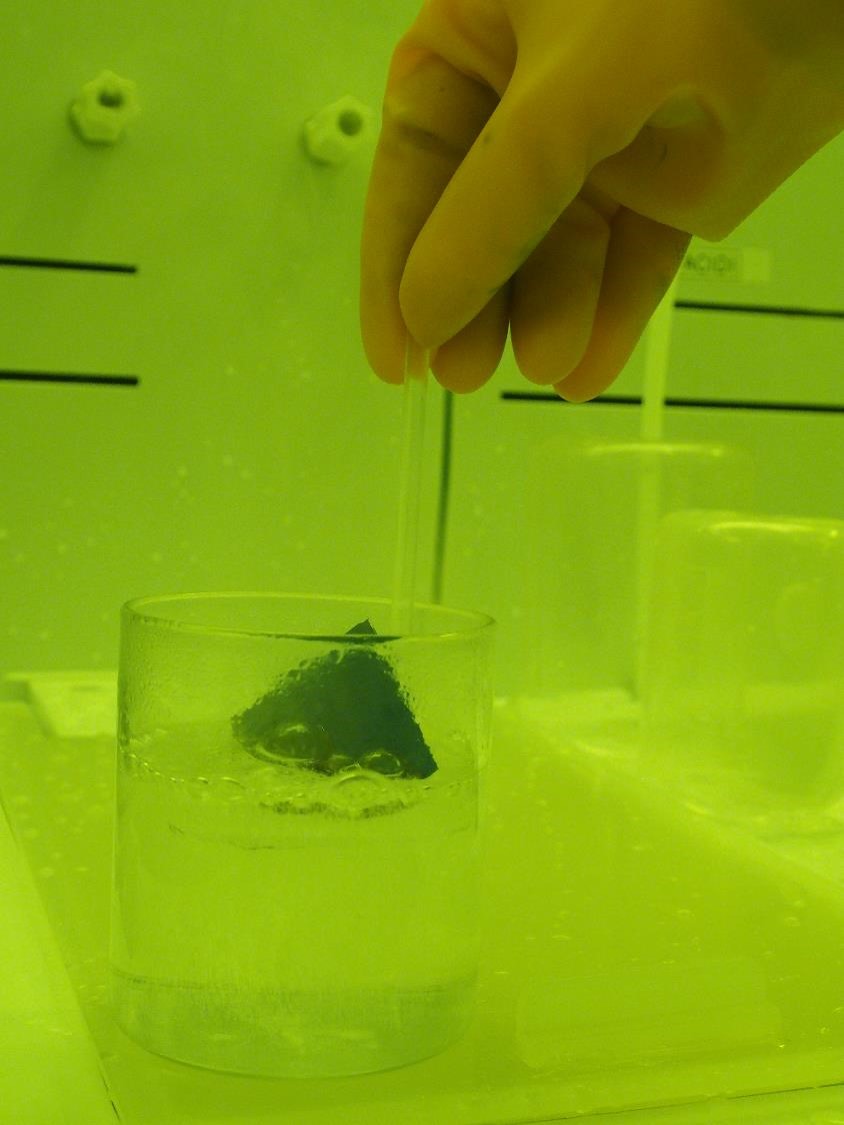
|
- PIRANHA
- RCA1, RCA1 MODIFIED, AND RCA2
- WET STRIPPING AND POLISHING BY ACETONE AND ISOPROPANOLE
|